
来源|半导体业观察
1987年成立的台积电,在最初的25年都是无惊无险地尾部发展,直到2011年凭借全新的封装技术InFO首度拿下苹果订单后,在手机巨头倒逼下,加上产业发展的天时地利,台积电迎来了高速发展的十年。
于苹果而言,得益于台积电在工艺和封装技术的不断精进发展,且较快的步速,为苹果芯片帝国的崛起起到了强大的背后支撑。
台积电和苹果虽各自为道,却又互相制约,走进了芯片发展的正向循环。
苹果之于台积电
作为台积电的第一大客户,苹果贡献的营收是台积电第二大客户3倍多,以至于苹果不用像其他客户一样为产能预付费用。台积电2021年财报显示,第一大客户(也就是苹果)贡献营收达到4054.02亿元,年增20%,占公司营收比重达到26%。
而且据DigiTimes报道,2022年台积电预计将收获来自苹果170亿美元的收入,高于2021年的138亿美元。主要是因为除了手机芯片之外,苹果预计到2022年底,将用M系列芯片全面替换英特尔X86平台,年出货规模近2000万台的Mac系列,也成为台积电今年HPC营收增长的关键之一。在可预见的未来,台积电预计仍将是苹果的唯一芯片供应商,三星在先进工艺良率方面遇到问题,英特尔不太可能收到苹果的订单。
苹果为台积电创造的订单是直观的收入,而另一大更深远的影响是,在苹果的参与下,台积电得以创造出很多新技术,特别是在先进制程方面,苹果的重要性越来越凸出。
首先要说的是扇出封装(Fan-Out Package),在2000年代中期,飞思卡尔和英飞凌分别推出了业界首个扇出封装类型RCP和eWLB。2006 年,飞思卡尔推出了一种称为再分配芯片封装 (RCP) 的扇出技术,在2010年,飞思卡尔将RCP授权给Nepes,Nepes 在韩国建立了一条 300mm生产线来生产RCP技术。2007 年,英飞凌将eWLB技术授权给ASE,后来,英飞凌将eWLB授权给现在由Amkor拥有的Nanium。此后虽然经历了一系列的发展,但扇出封装一直不温不火。
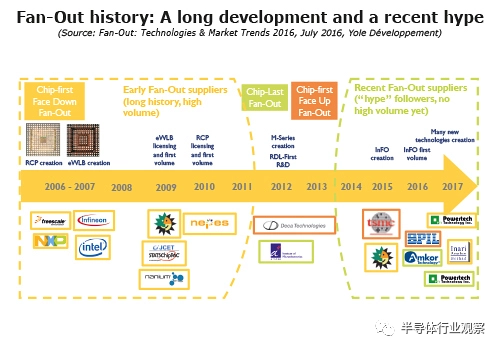
Fan-out发展史(图源:Yole)
直到2016年,在苹果和台积电双方的合作下,已经发展多年的扇出封装技术迎来了重要的转折点。2016年苹果iPhone 7系列手机的A10应用处理器开始采用Fan-Out技术,这为Fan-out创造出庞大的需求量,再加上台积电的技术突破下,Fan-out可支援的I/O数量大增。两者的强强联手将扇出型封装带向了新高度。如今,扇出封装技术已变得无处不在,而且现在正成为应对异构集成挑战的不二之选。
再一个成功的技术,最新款的苹果电脑处理器M1 Ultra所用的先进封装技术UltraFusion,也是两家合作的成果。在上月3D IC和异构集成国际研讨会上,台积电展示的演示文稿中证实,苹果使用的是其InFO_LI 封装方法来构建其M1 Ultra处理器并启用其UltraFusion芯片到芯片互连。InFO_LI在多个裸片下方使用局部硅互连,而不是使用大型且昂贵的中介层,这一概念与英特尔的嵌入式裸片互连桥 (EMIB)非常相似。苹果也是最早使用 InFO_LI 技术的公司之一。

(图片来源:台积电/Tom Wassick/Twitter)
另外,据说苹果已经订购了 2nm 芯片,将在 2025 年由台积电完成。而且苹果和台积电正在联合开发1nm芯片,用于增强现实头戴设备和苹果的汽车项目。关于1nm技术,据台积电发布在Nature上的文章,台积电工程师表示,他们找到了一种电阻极低、电流强度大的材料,可用作晶体管的接触电极。它是一种铋(Bi)半金属,不仅满足1纳米工艺技术的要求,而且还适合量产。台积电目前使用钨互连,而英特尔使用钴互连,两者都有其优势,并且都需要特定的工厂工具。虽然1nm芯片在未来几年内不太可能成为现实,选择铋半金属也远非事实。但是,台积电明确表示,他们正在朝着这个方向积极努力。
所以综合来看,苹果作为台积电新技术的大客户,不仅为台积电带来了新技术的突破,也将有助于台积电提升其基于新技术的产能,并进一步优化工艺,最终将这些新工艺为其他客户提供服务。
苹果离不开台积电
因为台积电的代工支持,苹果自研芯片一路高歌猛进,苹果也在供应链获得更多自主权。
首先是手机芯片,自2010年苹果内部设计出第一款处理器A4,彼时苹果的处理器订单还是由三星负责代工,但是台积电早已秘密地与苹果进行联合研发和技术攻关,台积电最早是为苹果A6芯片解决设计问题。到2013年台积电正式开始为苹果代工A8处理器,搭载A8芯片的iPhone 6也被称为苹果最畅销的产品,截至2019年停产共出货约2.5亿台。而随着三星代工的A9芯片功耗不如台积电低,此后,A9以后的每一代A系列芯片,都是由台积电独家代工,到现在苹果的A系列芯片已经到了A15仿生芯片。
再就是现在苹果大获成功的电脑芯片M系列,使其摆脱了对英特尔的控制,并让苹果将自己与PC行业的其他公司进一步区分开来。据消息人士@手机晶片达人爆料称,台积电有一个300人的团队,涵盖研发、设计、先进工艺和封装,在与苹果深度合作开发PC、NB等产品的下一代CPU。
苹果最新款电脑Mac Studio的核心处理器芯片M1 Ultra,是将两个M1 Max芯片拼接在一起,据了解,其最大的技术进步在于芯片拼接技术UltraFusion,分析师认为,这种技术非常依赖来自台积电的底层芯片制造工艺。这个团队无疑是苹果M系列芯片成功背后的关键之一。
苹果还将在2022年推出第二代M系列芯片,采用升级的5纳米工艺。因此,与M1一代相比,性能和效率的提升会相对较小。而值得注意的是,苹果预期在2023年发布基于3nm的第三代M系列芯片,代号为‘Ibiza’, ‘Lobos’和‘Palma’,高端版本有高达40个CPU核,3nm将成为苹果第三代M系列芯片的主要亮点,据悉,3nm最大的提升来自于逻辑门密度,预计可达5nm节点的1.7倍,同时功耗相比5nm也有高达30%的改善,晶体管速度方面也有10-15%的提升。
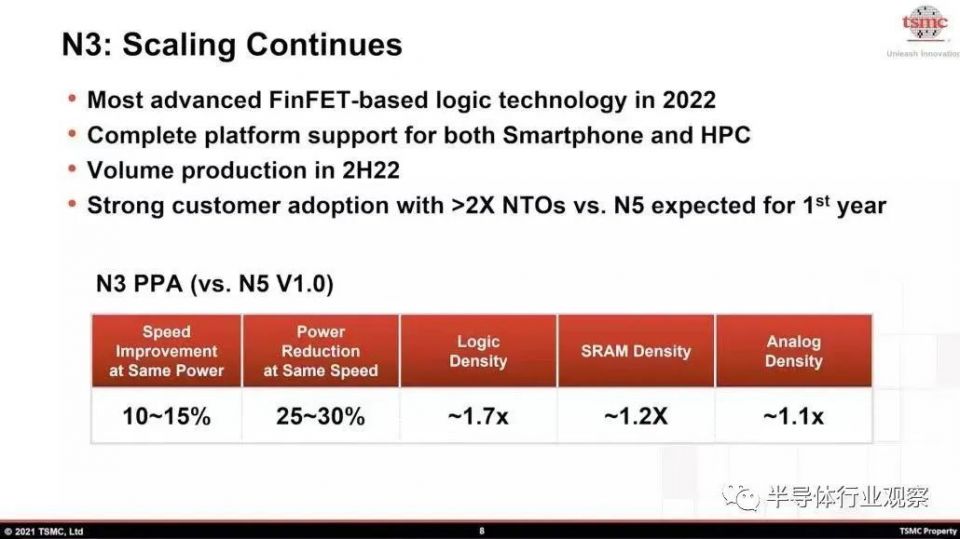
然后是基带芯片,因为自2023年开始,苹果将开始使用自研的基带芯片。根据苹果与高通的协议,苹果承诺在2022年6月1日至2024年5月31日期间使用后者的骁龙X65和X70基带芯片,那么等苹果5G基带芯片自研成功以后,势必也将逐渐摆脱对高通的依赖。而供应链消息,台积电凭借先进制程通吃苹果5G射频芯片订单,市场人士分析,相关芯片将采用台积电6纳米RF制程生产,预计年需求将超过15万片。
台积电的6纳米制程隶属于7纳米家族,于2021年台积电首次对外发表,也是主要用来支持5G手机的先进射频技术,并改善5G手机芯片尺寸和功耗提高的难题。依据台积电的说法,6纳米RF制程针对6GHz以下及毫米波频段的5G射频收发器能提供大幅降低的功耗与面积,同时兼顾消费者所需的效能、功能与电池寿命,亦将强化支持WiFi 6/6e的效能与功耗效率。
除此之外,苹果还有Apple Watch的W系列芯片、AirPods的H系列芯片、Mac上的T系列安全芯片,以及iPhone上的U1超宽带芯片等。这其中多数芯片都是由台积电代工生产的。
更为值得一提的是,苹果正在研发的自动驾驶AI芯片也早与台积电展开合作,Apple Car被描述为苹果的“下一个明星产品”。据TheElec的报道,Apple正在与一家韩国外包半导体组装和测试 (OSAT) 公司合作开发用于其Apple Car的芯片模块和封装,报道中指出,苹果采用的方法据说与 M1芯片的开发相同,其中单个模块最初作为独立芯片制造用于测试目的,然后再将电路集成到单个芯片中。DigiTimes的业内消息人士称,苹果据称正在与一家韩国基板生产商进行谈判,以供应基于 ABF 的倒装芯片球栅阵列 (FC-BGA) 基板,专门用于Apple Car 芯片。此举将使得苹果再开拓新的芯片帝国版图。
结语
台积电与苹果的合作始于十年前(其实更早),两家公司彼此成就,在十年后的今天都成为了各自赛道的领头羊。没有苹果这么强势的客户的帮助,台积电难以在代工界领先。而如今,无论是苹果的A系列、M系列、还是基带芯片,乃至未来的汽车芯片,都将离不开台积电的代工支持。这两家公司已经密不可分,未来,两家还将互相倚仗着走得更远。
但愿每个代工厂在发展之路上都有一个“苹果”对其提出要求,每个IC设计企业都有一个“台积电”一直为其不断的提供支持。
